大口径SOIウエハーの欠陥評価装置
宇宙科学研究所
宇宙科学研究所はこのほど,次世代デバイス用基板として大きな注目を集めているSOI (Silicon-on-Insulator) ウエハーの品質を高速かつ高感度に評価できるフォトルミネッセンス・マッピング装置を開発した。
SOIウエハーは,酸化膜のついたシリコン基板の上に50〜200ナノメータ(1ナノメータは10億分の1メートル)程度の極薄のシリコン層を積んだ構造である.この表面シリコン層にデバイスを作り込む。SOIデバイスには,高速性,低電力性,そして耐放射線性といったメリットがあるので,高性能プロセッサ,携帯機器用デバイス,そして宇宙用デバイス等での普及が急速に広がっている。これに呼応してSOIウエハーの開発が急ピッチで進み,通常のシリコンウエハーと同様に口径200?のものが市販されており,300?ウエハーも発表されるに至っている。ここで表面シリコン層の品質がデバイス特性の鍵を握るので,欠陥評価が大きな課題となってくる。従来技術ではこのように薄いシリコン表面層の電子的性質を調べることは非常に困難であり,革新的な手法の開発が切望されていた。
当所の田島道夫教授は,SOIウエハーに紫外線レーザーを照射すると,凝縮ルミネッセンスと呼ばれる特有の発光現象が起きることを発見した。紫外線はシリコン中には5〜10ナノメータしか入ってゆかない。したがって極薄のシリコン層の中だけに電子・正孔を発生させることができる。電子・正孔はSOI構造の閉じ込め効果によって凝集状態となり,特有の発光現象が現れる。この発光は表面シリコン層中の欠陥や界面に非常に敏感に影響を受けるので,品質評価に利用できる。今回,日本学術振興会・未来開拓学術推進事業研究プロジェクト「ナノメータ・デバイス対応のSOIウエーハに対する極限評価技術の開発」により開発した装置では,口径300?までのSOIウエハーに対応可能で,レーザーをウエハー面上で走査させ,各位置からの発光強度をマッピングすることによって,ウエハー面内の欠陥分布,界面特性分布を調べることができる。
本装置は,(1) 深紫外線から近赤外線に至る波長領域のレーザーを励起源として使用,(2) 可視光から赤外光の波長領域の発光を分光して検出,(3) 300 mmウエハーの全面をマッピングし特定の部分を1μmの分解能までズームアップ,という特長を持つ。ウエハーのステージは残留歪み・熱膨張の小さいグラナイトを使用し,エアベアリングとリニアモータ駆動により,高速(100 mm/s)で高精度(±0.3 μm)の移動ができる。200 mmウエハーの全面マッピングに要する時間は約20分である。同装置を,市販の各種SOIウエハー(SIMOX, Unibond®, ELTRAN®)に適用した結果,これまでに観測することの出来なかったミクロンサイズの微小欠陥や,各種法に特有の欠陥分布の不均一性を明瞭に観測することに成功した。図はSOIウエハーの全面マッピングと欠陥部分のズームアップの1例で,暗い部分が品質の悪いところに対応している。このような欠陥パターンはこの装置によって初めて明らかにされたものである。
この装置に関しては,昨年末に米国で開催された電気化学会において速報として発表されたが,内外より大きな反響があり,今月末にフランスで開催される国際SOIシンポジウム,9月に日本で開催される国際固体素子材料コンファレンスで招待講演が依頼されている。また同装置の製造を担当したフォトンデザイン(株)において商品化が予定されている。さらに米国の測定装置メーカーより技術指導・技術移転の打診がある。
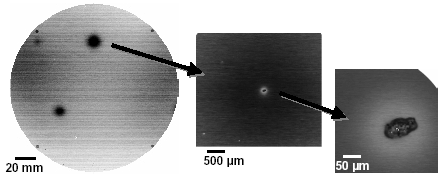
口径200 mm SOIウエハーの全面マッピング(左)と欠陥部分のズームアップ

フォトルミネッセンス・マッピング測定装置に300 mmウエハーをセットする田島教授